
従来のエリプソメーターは方位分解能が約50μmぐらいで、膜厚測定はレーザースポットがあたる1点のみを測定していました。
これに対しイメージングエリプソメーターEP4シリーズは方位分解能1μmを達成、膜厚分布の3Dマップ化が可能で、ミクロレベルの構造体やバターン形状のある表面上の膜観察・厚み解析に最適なソリューションです。
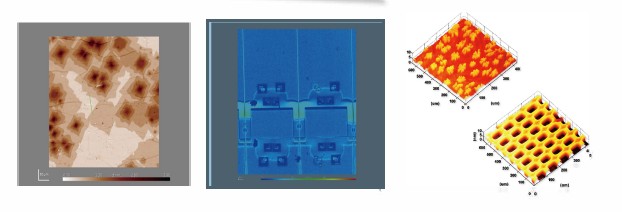
エリプソメトリーとは
エリプソメトリーとは物質の表面で光が反射するときの偏光状態の変化(入射と反射)を観測し、そこから物質に関する情報を求める方法で、測定にはエリプソメーターを使用します。
エリプソメトリーの呼び名は、反射光の偏光測定値状態が一般に楕円(elliptical)になる事に由来しています。
Accurion社は消光型エリプソメトリー( Null ellipsometry)を利用して画像エリプソメトリー(imaging ellipsometry)を行っています。
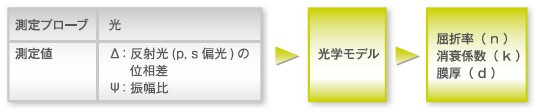
イメージングエリプソメーターの機器構成
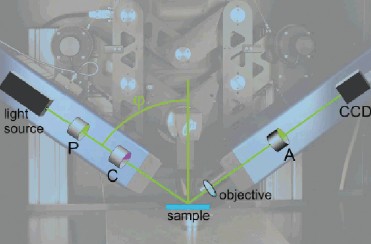
PCSAコンフィギュレーション
(P)偏光子(C)補償子(S)試料(A)検光子
データの解析
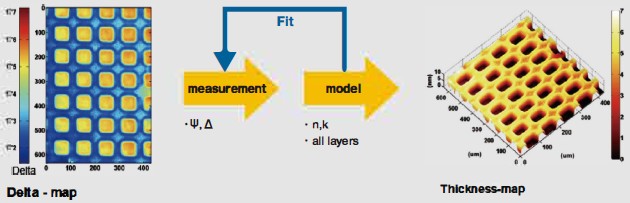
製品特長
マクロな領域の全体像を観察してからローカルな領域にフォーカスする事ができます。
グラフェン、MEMS、有機薄膜、バイオチップなど様々なアプリケーションにこの特長を利用する事ができます。

AFMをインテグレートし、エリプソメーターとAFM両方による観察が可能です。

ハードディスク磁気ヘッドスライダーのエリプソメーター、AFMでの観察、及び構造のモデル化
SPR(表面プラズモン共嗚)のフローセルをインテグレートし、バイオセンサーのアプリケーションに対応可能
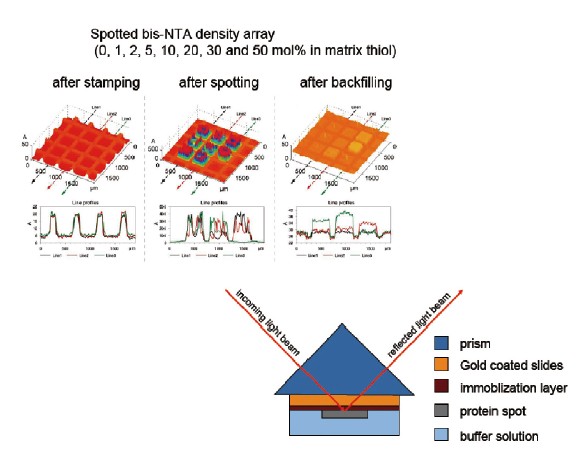
ブリュスター角顕微鏡

媒質界面での電気双極子放射において、電気双極子の振動方向が反射光の
振動方向と直行する場合P偏光の反射光が消失し、この角度はブリュスター
角と呼ばれます。気/液界面上に両親媒性の単分子膜を展開した場合、
ブリュスタ一条件がくずれて反射光をCCDカメラでとらえる事ができ、
これにより試料の画像を得る事が出来ます。

LB膜作成装置(トラフ)上にセットしたEP4 Ultrabam
※Ultrabamはイメージングエリプソメーターにアップグレードが可能です。
アプリケーション
- グラフェン
- 光学薄膜の評価
- 有機薄膜(有機EL・有機半導体他)の評価
- 生体工学・材料の評価
- MEMS薄膜の評価
- 単分子膜・SAM膜の観察と評価(気/液、液/液界面)
アクセサリー/オプション
ビームカッター
ガラス、ポリマーフィルムなど基板が透明で膜厚がビーム径より小さい場合は、基板表面の反射と底部の反射がCCD カメラに達するまでに干渉しあいます(上図左)。
ビームカッターでビーム径を小さくし、基板表面の反射と底部の反射を分けること(上図右)により、基板表面の反射を検知し、膜厚計算の精度を高める事ができます。
水平方向、垂直方向、および入射角で調節できます。
ビームエクスパンダー
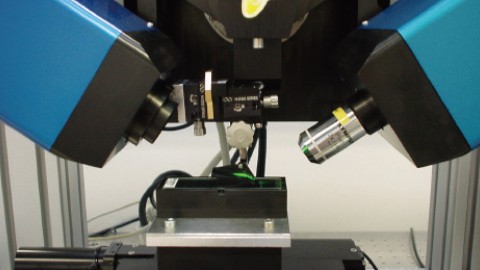
補償子とサンプルの間に設置するレンズでビーム径を7倍大きくし、比較的大きな視野に対して均ーにビームを照射します。
2xと5xの対物レンズに適しています。
レーザーセーフティーキャビネット

防塵及びレーザー光のプロテクションの機能があります。アクリルガラスはレーザーの波長にあわせ光を吸収するように着色されていますが、装置を見ての操作には支障ないような度合いです。
インターロックでドアを開くとレーザーが停止するようになっています。
UV/NIRカメラ
UV/ NIR波長への拡張アップグレードをする場合に必要になります。
波長範囲25 0nm-1700nm、1 280X1040ピクセル、3 0fps
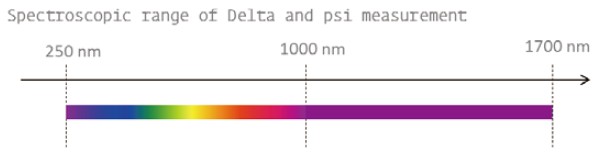
ライトガイド

液/ 液または固体・液体界面へとレーザー光路を誘導し調整するため
のアシスト用ガイドです。(入射角対応範囲40-72°)
特に透明な液/液界面上の観察用途に最適であり、強く推奨致します。
ミュラーマトリックス
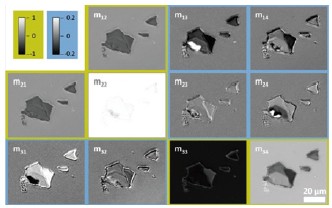
異方性を持つ試料の測定に適しています。
製品モデル
仕 様
イメージングエリプソメーターEP4/ブリュスタ一角顕微鏡EP4 BAM共通
光学系
| 光源 | 固体レーザー 波長: 650nm (他の波長のレーザーも可能です) 出力: 15mW、20mW、50mW |
| 単色光分光器 | 46干渉フィルター(分光エリプソメーターEP4に使用) 波長範囲360 – 1000nm、バンド幅±6nm |
| LDLS (オプション) |
レーザー安定化キセノンアークランプ 200nm – 2000nm の範囲で連続出力が可能。 光源寿命10,000時問 |
| 対物レンズ (2x,5x,10x,20x,50x,の合計5種類) |
 |
| 偏光子 | Glan-Thomson |
| 入射角 | 40-90度 |
機械系
自動ゴニオメーター
ゴニオメーターはソフトウェアで自動制御する事ができます。
EP4 ソフトウェア上から多入射角測定を自動で行う事も可能です。
回転軸にはペアリングや機械的な取り付け具を使用していません。
角度範囲: 40-90度
角度分解能: 0.001度
角度の絶対精度: 0.01度
動作速度:可変、約5度/秒より

この機構によりゴニオメーターのデザインによって試料サイズが制限されることはありません。
自動アライメントステージAutomatic Alignment Stage (ALS)
サンプル真上のカメラに切り替わり、レーザーの反射光スポットが表示されます。
水平方向のサンプルステージ角度を自動調節する事ができます。
操作はワイヤレスジョイスティックで行なう事ができます。
自動/マニュアルサンプルステージどちらとも組み合わせる事ができます。
精度: 0.01度
分解能:0.001度(最小ステッブ)

Z 軸リフト
ブリュスタ一角顕微鏡としてLB 膜作成装置と一緒に使用する場合、界面での下層液の蒸発を感知し、BAMの高さを自動調節します。
偏光子動作精度
モーターによる回転動作分解能: 0.001度
自動サンプルステージ
X,Y,Z自動制御
移動範囲: 90mm (X/Y)、10mm(Z)
再現性: 1 um (X/Y)
分解能: 1 um(X/Y)
操作はワイヤレスジョイスティックから実施する事も可能です。

マニュアルサンプルステージ
X,Y,Z手動制御
移動範囲: 100mm (X/Y)、12mm(Z)
分解能: 0.001度

画像処理
CCDカメラ(標準搭載品)
画素数: 1392×1040
画像ファイル
png,jpg,bmp,TIFF
フォーカススキャナー

スライダーを動かしシャープな画像に合わせる事ができ、視野全体で焦点の合った画像が得られます。
ソフトウェア
ユーザーインターフェース
EP4 Viewグラフィカルユーザーインターフェース
スクリプト言語
マクロ言語EP3スクリプトにより複雑な操作を簡素化しています。
マッピング
3Dマッピング機能。
誘電関数モデル
Cauchy, Lorentz, FourBloom, Bruggemann他
制御系
PC
・Windows OS
・17″ TFTモニター
・専用100メガビットのイーサネットを介してホストパソコンと通信
ユーティリティー
電源
100-240VAC,50/60Hz,1 OA
Δ/Ψ測定精度(エリプソメーター)
| 相対誤差 | 絶対誤差 | 精度 (測定間再現性) |
|
| Si02/Si(0-25nm) | 9%@10 nm 3%@20 nrn |
0.8 nm | 0.004 nm 0.004 °Delta 0.002 °Psi |
| Si02/Si(50nm) | 2% | 1 nm | 0.01 nm |
| Si02/Si(100nm) | 1% | 1 nm | 0.01 nm |
| Au基板/有機薄膜 (10nm以下) |
n/a (No certified reference sample) |
n/a (No certified reference sample) |
0.005 nm 0.003 °Delta 0.004 °Psi |
| 屈折率(100nm.Si02/Si) | 0.5% | 0.01 | 0 0001 |